Kontakt
Postanschrift
Besuchsanschrift
Rasterkraftmikroskopie (SFM) oder Atomkraftmikroskopie (AFM)


Gerät
Controller: Nanoscope IIIA (Veeco), Quadrex Extension Box
Messköpfe: Dimension 3100, Enviroscope, Bioscope (alle Veeco)
Erweiterungen: Pulsed force mode (Witec), Leitfähigkeitserweiterung (Veeco)
Spezialanwendungen: Arbeit in Lösung, Arbeit in kontrollierten Gasatmosphären, große Proben
Kontaktmodus und Tapping-Modus
Zur Bestimmung der Topographie werden in unserer Gruppe der Kontaktmodus (contact mode) und ein als Tapping Mode (mögliche Übersetzungen Abklopfmodus/ intermittierender Kontaktmodus) bezeichneter Messmodus verwendet. Im Kontaktmodus wird die Messspitze in direkten Kontakt mit der Probe gebracht. Der Anpressdruck wird durch die Verformung des Cantilevers erfasst und beim Abrastern der Probe durch eine Rückkopplungsschleife konstant gehalten.
Im Tapping Mode wird der Cantilever durch eine zusätzliche Piezokeramik, an die eine hochfrequente Wechselspannung (ca. 10-500 kHz) angelegt wird, nahe seiner Resonanzfrequenz in Schwingung versetzt. Bei Annäherung an die Probe verringert sich die Amplitude der Schwingung durch Wechselwirkungen zwischen Probe und Messspitze. Eine Rückkopplungsschleife hält bei der Bewegung über die Probe die Amplitude durch Variation der z-Position konstant, so dass topographische Informationen über die Probe erhalten werden. Beide Messmodi können unter atmosphärischen Bedingungen, im Vakuum und in Flüssigkeit betrieben werden.
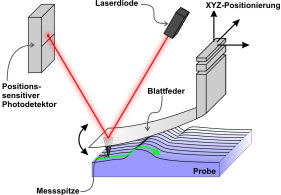


Materialeigenschaften: Pulsed Force Mode und Lateral Force Mode
Im Pulsed Force Mode wird die Position des z-Piezos sinusförmig moduliert (ca. 300 - 1000 Hz), so dass die Position der Messspitze zwischen frei schwebend und auf die Probe aufgedrückt pendelt. Durch Analyse der auf diese Weise kontinuierlich aufgenommenen Annäherungs-/Retraktionskurven können lokale Informationen über die Festigkeit und Adhäsion der Probe erhalten werden.
Der Lateral Force Mode (Reibungskraftmmodus) ist eine Variation des Kontaktmodus. Die schnelle Scanrichtung wird um 90° gedreht, so dass der Cantilever senkrecht zu seiner Ausrichtung bewegt wird. Infolgedessen wird der Cantilever durch Reibungskräfte zwischen Messspitze und Probe verdrillt. Je nach "Klebrigkeit" der Probe variiert die Verdrillung, die durch einen viergeteilten Fotodetektor aufgezeichnet wird. Aus diesen Daten wird ein Abbild der lokalen Reibungskräfte erstellt.
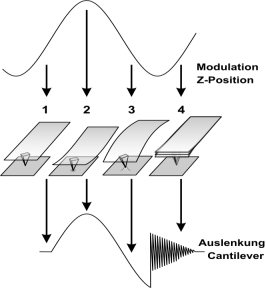

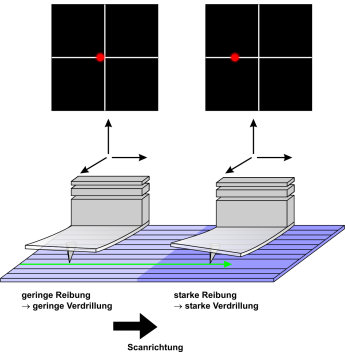

Leitfähigkeitsrasterkraftmikroskopie
Die Leitfähigkeitsrasterkraftmikroskopie (CAFM, conductive atomic force microscopy) ist ein Messmodus, der aus dem Kontaktmodus hervorgegangen ist. Hierbei wird eine Potentialdifferenz zwischen einer leitenden Messspitze und der (leitenden oder halbleitenden) Probe angelegt, so dass Leitfähigkeitsvariationen auf der Probenoberfläche über den fließenden Strom gemessen werden können. Gleichzeitig wird im Kontaktmodus ein topographisches Abbild der Oberfläche gewonnen.



Hintergrundinformationen und Details zu diesem Experiment und zu dieser Probe: S. E. Pust, D. Scharnweber, C. Nunes Kirchner, G. Wittstock; Heterogeneous Distribution of Reactivity on Metallic Biomaterials: Scanning Probe Microscopy Studies of the Biphasic Ti Alloy Ti6Al4V. Adv. Mater. 2007, 19, 878-882. Abstract & Link

